当前位置:仪器网 > 产品中心 > 行业专用仪器>其它行业专用仪器/仪表>半导体专用检测仪器设备>WD4000 晶圆形貌检测设备
返回产品中心>WD4000 晶圆形貌检测设备
| 参考价 | ¥ 9999999 |
| 订货量 | ≥1台 |
- 公司名称 深圳市中图仪器股份有限公司
- 品牌
- 型号 WD4000
- 所在地 深圳市
- 厂商性质 生产厂家
- 更新时间 2023/10/20 9:37:23
- 访问次数 122
当前位置:仪器网 > 产品中心 > 行业专用仪器>其它行业专用仪器/仪表>半导体专用检测仪器设备>WD4000 晶圆形貌检测设备
返回产品中心>| 参考价 | ¥ 9999999 |
| 订货量 | ≥1台 |

|
WD4000晶圆形貌检测设备提供几何轮廓分析、粗糙度分析、结构分析、频率分析、功能分析等五大分析功能。几何轮廓分析包括台阶高、距离、角度、曲率等特征测量和直线度、圆度形位公差评定等;粗糙度分析包括国际标准ISO4287的线粗糙度、ISO25178面粗糙度、ISO12781平整度等全参数;结构分析包括孔洞体积和波谷。
WD4000晶圆形貌检测设备自动测量Wafer厚度、表面粗糙度、三维形貌、单层膜厚、多层膜厚。
1、使用光谱共焦对射技术测量晶圆Thickness、TTV、LTV、BOW、WARP、TIR、SORI等参数,同时生成Mapping图;
2、采用白光干涉测量技术对Wafer表面进行非接触式扫描同时建立表面3D层析图像,显示2D剖面图和3D立体彩色视图,高效分析表面形貌、粗糙度及相关3D参数;
3、基于白光干涉图的光谱分析仪,通过数值七点相移算法计算,达到亚纳米分辨率测量表面的局部高度,实现膜厚测量功能;
4、红外传感器发出的探测光在Wafer不同表面反射并形成干涉,由此计算出两表面间的距离(即厚度),可适用于测量BondingWafer的多层厚度。该传感器可用于测量不同材料的厚度,包括碳化硅、蓝宝石、氮化镓、硅等。
1、厚度测量模块:厚度、TTV(总体厚度变化)、LTV、BOW、WARP、TIR、SORI、平面度、等;
2、显微形貌测量模块:粗糙度、平整度、微观几何轮廓、面积、体积等。
3、提供调整位置、纠正、滤波、提取四大模块的数据处理功能。其中调整位置包括图像校平、镜像等功能;纠正包括空间滤波、修描、尖峰去噪等功能;滤波包括去除外形、标准滤波、过滤频谱等功能;提取包括提取区域和提取剖面等功能。
4、WD4000晶圆形貌检测设备提供几何轮廓分析、粗糙度分析、结构分析、频率分析、功能分析等五大分析功能。几何轮廓分析包括台阶高、距离、角度、曲率等特征测量和直线度、圆度形位公差评定等;粗糙度分析包括国际标准ISO4287的线粗糙度、ISO25178面粗糙度、ISO12781平整度等全参数;结构分析包括孔洞体积和波谷。
品牌:CHOTEST中图仪器
型号:WD4000系列
厚度和翘曲度测量系统
可测材料:砷化镓 ;氮化镓 ;磷化 镓;锗;磷化铟;铌酸锂;蓝宝石;硅 ;碳化硅 ;玻璃等
测量范围:150μm~2000μm
扫描方式:Fullmap面扫、米字、自由多点
测量参数:厚度、TTV(总体厚度变 化)、LTV、BOW、WARP、平面度、线粗糙度
三维显微形貌测量系统
测量原理:白光干涉
干涉物镜:10X(2.5X、5X、20X、50X,可选多个)
可测样品反射率:0.05%~100
粗糙度RMS重复性:0.005nm
测量参数:显微形貌 、线/面粗糙度、空间频率等三大类300余种参数
膜厚测量系统
测量范围:90um(n= 1.5)
景深:1200um
最小可测厚度:0.4um
红外干涉测量系统
光源:SLED
测量范围:37-1850um
晶圆尺寸:4"、6"、8"、12"
晶圆载台:防静电镂空真空吸盘载台
X/Y/Z工作台行程:400mm/400mm/75mm
如有疑问或需要更多详细信息,请随时联系中图仪器咨询。

1、无图晶圆厚度、翘曲度的测量

通过非接触测量,将晶圆上下面的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度、粗糙度、总体厚度变化(TTV),有效保护膜或图案的晶片的完整性。
2、无图晶圆粗糙度测量
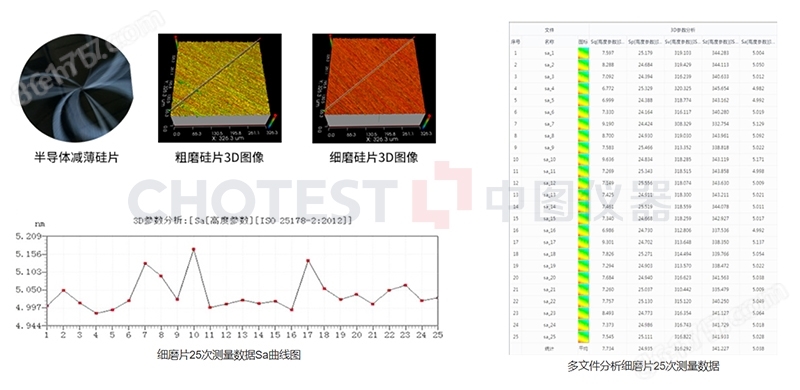
Wafer减薄工序中粗磨和细磨后的硅片表面3D图像,用表面粗糙度Sa数值大小及多次测量数值的稳定性来反馈加工质量。在生产车间强噪声环境中测量的减薄硅片,细磨硅片粗糙度集中在5nm附近,以25次测量数据计算重复性为0.046987nm,测量稳定性良好。
恳请注意:因市场发展和产品开发的需要,本产品资料中有关内容可能会根据实际情况随时更新或修改,恕不另行通知,不便之处敬请谅解。

|

|

|

|

|

|
*您想获取产品的资料:
个人信息: